PVA TePla社 プラズマ処理装置
PVA TePla
GIGA シリーズ(前工程)
ウエハープロセスモデル
PVATePlaの前工程用プラズマ装置は、半導体・MEMS・光デバイス等、多くのアプリケーションにおいて世界中で広く使用されており、最大限のプロセス再現性、歩留まり向上を提供致します。2.45GHzのマイクロ波で励起された高密度のプラズマと、イオンの運動エネルギーを抑制することで、ダメージレスのプロセス結果を得ることができます。ウエハープロセスにおけるアッシング・レジスト剥離・MEMSなどのSU-8レジストアッシング・デスカム処理・基板の表面クリーニングや表面活性化など、幅広いアプリケーションに対応できるよう設計されております。
SERIES LINEUP
シリーズラインナップ-
バッチ式マイクロ波プラズマ装置

GIGA batch 310/360/380M
マニュアルのバッチタイプは、研究開発から試作・パイロットライン・小規模量産まで、最も費用対効果の高い装置になります。
-
バッチ式移載機搭載プラズマ装置

GIGA batch 360/380P
自動開閉ドア付きのチャンバーと移載機により、カセットから一度にウエハを取り出し、チャンバーへ搭載する機能を備えています。
-
枚葉式マイクロ波プラズマ装置

GIGA fab M/A (200/300)
ウエハの枚葉プロセスに対応し、基板の種類や、マニュアルローディング~完全自動に応じて、様々な機器構成を選択できます。
製品特徴
ダメージレスプロセス
RF(13.56MHz)で励起されたプラズマ中では、電界の変化によりイオンや電子は揺動されやすく、質量の軽い電子は電極側に衝突します。その結果、ウエハが置かれた電極側には電子がチャージされていきます。この時生じるマイナスのポテンシャルを自己バイアスと呼びます。自己バイアスによりイオンは電極側へ加速され基板表面に衝突します。他方、マイクロ波(2.45GHz)のように比較的周波数が高いと、電子やイオンが電界に追い付かず変位が小さいため基板や電極への衝突がなく、自己バイアスが非常に低くなります。RFは励起されたプラズマが、物理的なエッチングを伴うのに対し、マイクロ波は主に化学的な反応で表面処理を行います。
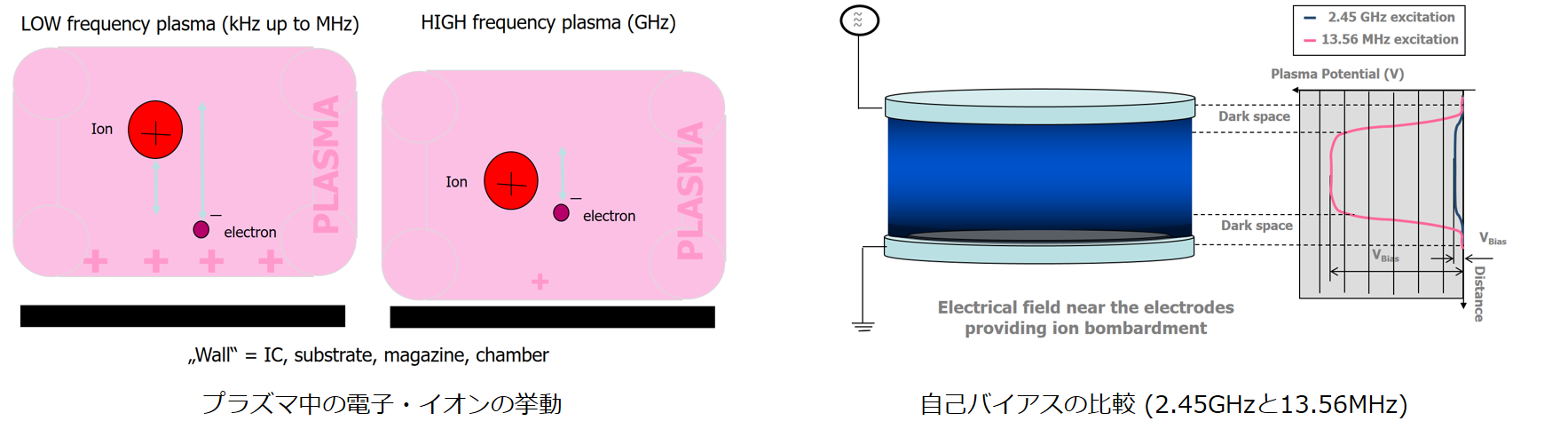
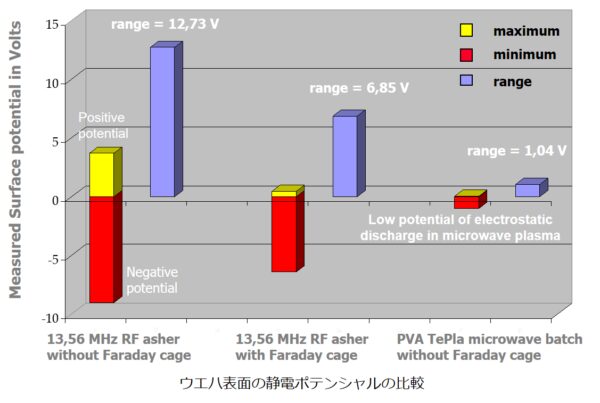
バッチ処理で高いスループットを実現
PVAテプラ社の真空プラズマ装置は、アッシング装置としても多く採用されております。マイクロ波発生器を備えており、マスフローコントローラーに流量制御されたプロセスガスにより、高密度のプラズマをチャンバー内で生成します。真空チャンバー内部には電極がなくサンプルへのダメージ・金属によるコンタミを抑制します。
プロセスチャンバーはクォーツ製で、マイクロ波がチャンバー内へ伝播されます。マイクロ波はチャンバー内部に置かれたウエハに吸収され、ウエハの温度は上昇します。一部のマイクロ波のエネルギーは、プロセスガスに吸収され、ガスはプラズマ状態へと変化します。この2つの効果が、処理の早いレジスト剥離を促進します。ウエハが高温に敏感な場合、ファラデーケージにより、マイクロ波の吸収を防ぎ温度を低く保ちます。
バレル式の装置は、一度に50枚のウエハを搭載することが可能で枚葉処理のアッシング装置と比較して、特にイオン注入後のレジスト除去におけるスループットは、速い処理速度を実現することができます。枚葉処理の場合、急なウエハ温度上昇におけるレジストのポッピング現象を防ぐため、低温での処理を考慮する必要があります。しかしながらこれは、下のグラフが示すようにスループットを減らす要因になります。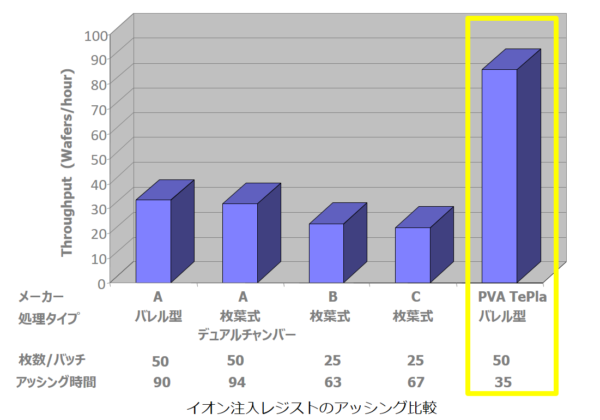
GIGA360/380P
GIGA360(~6″対応) /380P(~8″対応)では、マニュアル機の360/380M と同等のウエハ収容能力を持ち、自動でカセットから一度にウエハを取り出しチャンバーへセットすることが可能なウエハ移載機を備えております。半導体製造工程において、最も厳しい要求に適した装置で、クラス100のクリーンルームの要求に適合します。
300mm対応全自動枚葉プラズマ装置
GIGA fabはウエハの枚葉プロセスに対応し、基板の種類に応じてマニュアルローディングから完全自動まで対応しています。
GIGA fab M(マニュアルタイプ)では、チャンバーは引き出し型のドアがついており、ウエハはドアにマウントされた加熱または冷却プレートの上に置かれます。GIGAfab Aは、搬送ロボットによる全自動のプラットフォームになります。様々なウエハサイズのオープンカセットや、FOUP・SMIFステーションと組み合わせることも可能です。
GIGAfab A プロセス結果 300mm (参考値)
| アッシングレート | 500nm/min 以上 (基板ステージ常温) |
| 均一性 | 7.5% 以下 |
| セット時間 | (ゲートバルブ open to close) 5秒以内 |
| 排気時間 | 5秒以内 |
| 大気開放時間 | 5秒以内 |
| スループット | 60枚/時 (プロセス時間: 40秒) |
APPLICATION
アプリケーション-

犠牲層・SU-8レジスト除去
MEMS・微細加工などで使用される厚膜のレジストや、SU-8など剥離が困難なレジストも、メタル層へのダメージや剥離を抑えながら除去することが可能です。
- GIGA batch
- GIGA fab
-
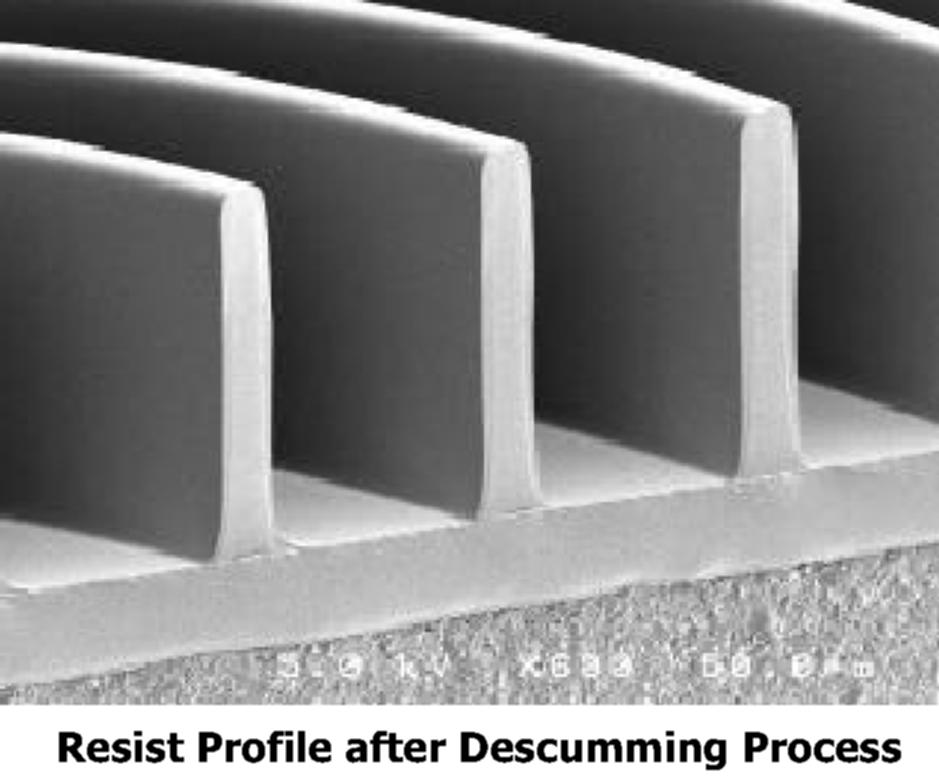
デスカム処理
微量のレジスト残渣も、レジスト形状への影響を最小限に抑えて処理します。低温処理を必要とするウエハレベルパッケージ(WLP)でのデスカム除去にも有効です。
- GIGA batch
- GIGA fab
-
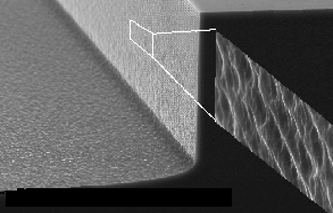
ボッシュプロセス後処理
ボッシュプロセスにより、側壁に付着したポリマーの残留物を、 反応ガスの比率や時間などを調整した適切なプロセスレシピにより、 ほぼ完全に除去します。
- GIGA batch
- GIGA fab