高温、低温ガスインジェクター(ガスソース)
RIBER(リベール)
ガスインジェクター
HTIシリーズ、LTIシリーズ、ガスモジュール
ガスソースMBEおよびCBEシステムで使用可能な高温、低温ガスインジェクター、並びにCBr4の導入を正確に制御することができるCBr4ガスデリバリーモジュールを紹介します。 (1) 高温ガスインジェクターは基板に衝突する前に分子種を熱分解。 (2) 低温ガスインジェクターは基板上でのクラック前に化合物の凝縮と解離を防止。 (3) CBr4ガスモジュールは超高純度ガスパネルとガスインジェクターを組み合わせ、p型ドーピングが必要なあらゆるMBEアプリケーションで使用可能。
SERIES LINEUP
シリーズラインナップ-
高温ガスインジェクター(ガスソース)

HTIシリーズ
NH3, AsH3, PH3,各種水素化物などを使用するガスソースMBEおよびCBEシステムで使用されます。 基板に衝突する前に分子種を熱分解するための高温ガスインジェクター
-
低温ガスインジェクター(ガスソース)

LTIシリーズ
TBAs, TBP, CBr4、各種有機金属材料などを使用するガスソースMBEおよびCBEシステムで使用されます。 基板上でのクラック前に化合物の凝縮と解離を防ぐための低温ガスインジェクター
-
CBr4ガスモジュール

ガスモジュールシリーズ
超高純度(UHP)ガスパネルと超高純度UHVガスインジェクタの利点を組み合わせ、CBr4の超低流量(< 5.10-3 sccm)の導入を正確に制御することができ、安全性と操作性を重視した設計を採用
高温ガスインジェクター(HTIシリーズ)
ガスソースMBEおよびCBEシステムで使用されるガスインジェクターの機能。
(1) 分子線エピタキシーチャンバーへのガスソースの導入
(2) 安定した均一な強度の分子線ビームの生成
(3) 材料組成の均一性を実現するために、1つのインジェクター内で同じ系列の異なるガスソースを事前に混合
(4) 必要に応じて種の事前クラッキング。
前駆体の性質と成長温度に対する熱的安定性に応じて、ガスインジェクターは、基板上でのクラック前に化合物の凝縮と解離を防ぐために低温(<100°C, LTIシリーズ)で動作させるか、または基板に衝突する前に分子種を熱分解するために高温(>600°C, HTIシリーズ)で動作させます。Riber社製のガスインジェクターは、標準的なUHVフランジを介してフランジに取り付けられており、ほとんどのガスソースのMBEおよびCBEシステムに設置することができます。ガスインジェクターには独立した1/4インチVCR®オス型ガスインレットがあり、LTI163シリーズでは最大2種類のプロセスガスに対応します。
ガスインジェクションラインには、高温の常閉式空気圧アクチュエータが装備されています(200℃以下)。校正されたリークは、アクセス可能な流量範囲を定義するためにランバルブレベルに設置されており、微調整はサーボバルブを介して行われ、バラトロンの圧力変換器によって制御されます。ベント出口は、CBr4ガスモジュール内のベントポンプに接続されています(カタログ参照)。
ソースの切り替えは、インジェクターに接続されたガスラインごとに用意された二方弁を用いたラン/ベント操作に基づいて行われます。これらのバルブは、UHVフランジの背面にあるVCRを介して取り付けられています。「ラン」(基板へ)と「ベント」(ベントポンプへ)の切り替えバルブは、エピタキシーチャンバーにできるだけ近い場所に設置されており、急激な層界面を形成するための低い過渡時間(1秒未満)でソースを迅速に切り替えることができます。
適用蒸着材料
NH3, AsH3, PH3,各種水素化物など
特徴
・ 安定した均一な強度の分子線ビーム
・ 空気圧式ラン/ベントバルブ – VCR接続による簡便な取り付け
・ 高温専用モデル – 水素化物、NH3、…
・ 実績のある設計を採用
・ 高信頼性、長寿命
高温ガスインジェクター概要図

製品スペック表
| 特性 | HT163 | HT1220 2V | HT1440 4V |
| 空圧モジュール | 外付け | インジェクター筐体内 | インジェクター筐体内 |
| 最大ガス導入数 | 1 | 2 | 4 |
| ランアクチュエータ数 | 1 | 2 | 4 |
| ベントアクチュエーター数 | 1 | 2 | 4 |
| ガス導入継手 | 1/4″ VCR | 1/4″ VCR | 1/4″ VCR |
| ガス出口ポート | KF16 | KF16 | KF16 |
| 動作温度 | 950℃ | 950℃ | 950℃ |
| 最大動作温度 | 1100℃ | 1100℃ | 1100℃ |
| ヒーター | シングルタンタルフィラメント | シングルタンタルフィラメント | シングルタンタルフィラメント |
| 熱電対 | Cタイプ | Cタイプ | Cタイプ |
| 最大アウトガス温度 | 1250℃ | 1250℃ | 1250℃ |
| 取付フランジ | CF63/ 他(アダプターフランジ変換) | CF63/ 他(アダプターフランジ変換) | CF63/ 他(アダプターフランジ変換) |
| 電源 | 電源 X1, 温度コントローラー X1 | 電源 X1、温度コントローラー X1 | 電源 X1、温度コントローラー X1 |
低温ガスインジェクター(LTIシリーズ)
ガスソースMBEおよびCBEシステムで使用されるガスインジェクターの機能。
(1) 分子線エピタキシーチャンバーへのガスソースの導入
(2) 安定した均一な強度の分子線ビームの生成
(3) 材料組成の均一性を実現するために、1つのインジェクター内で同じ系列の異なるガスソースを事前に混合
(4) 必要に応じて種の事前クラッキング。
前駆体の性質と成長温度に対する熱的安定性に応じて、ガスインジェクターは、基板上でのクラック前に化合物の凝縮と解離を防ぐために低温(<100°C, LTIシリーズ)で動作させるか、または基板に衝突する前に分子種を熱分解するために高温(>600°C, HTIシリーズ)で動作させます。Riber社製のガスインジェクターは、標準的なUHVフランジを介してフランジに取り付けられており、ほとんどのガスソースのMBEおよびCBEシステムに設置することができます。ガスインジェクターには独立した1/4インチVCR®オス型ガスインレットがあり、LTI163シリーズでは最大2種類のプロセスガスに対応します。
ガスインジェクションラインには、高温の常閉式空気圧アクチュエータが装備されています(200℃以下)。校正されたリークは、アクセス可能な流量範囲を定義するためにランバルブレベルに設置されており、微調整はサーボバルブを介して行われ、バラトロンの圧力変換器によって制御されます。ベント出口は、CBr4ガスモジュール内のベントポンプに接続されています(カタログ参照)。
ソースの切り替えは、インジェクターに接続されたガスラインごとに用意された二方弁を用いたラン/ベント操作に基づいて行われます。これらのバルブは、UHVフランジの背面にあるVCRを介して取り付けられています。「ラン」(基板へ)と「ベント」(ベントポンプへ)の切り替えバルブは、エピタキシーチャンバーにできるだけ近い場所に設置されており、急激な層界面を形成するための低い過渡時間(1秒未満)でソースを迅速に切り替えることができます。
適用蒸着材料
TBAs, TBP, Cbr4、各種有機金属材料
特徴
・ 安定した均一な強度の分子線ビーム
・ 空気圧式ラン/ベントバルブ – VCR接続による簡便な取り付け
・ 低温専用モデル – MOガス、CBr4、…
・ 実績のある設計を採用
・ 高信頼性、長寿命
低温ガスインジェクター概要図

製品スペック表
| 特性 | LTI163 |
| 最大ガス導入数 | 1 |
| ランアクチュエータ数 | 1又は2 (圧空モジュールタイプによる) |
| ベントアクチュエーター数 | 1又は2 (圧空モジュールタイプによる) |
| ガス導入継手 | 1/4″ VCR |
| 動作温度 | <100℃ |
| 最大動作温度 | 250℃ |
| ヒーター | シングルタンタルフィラメント |
| 熱電対 | Cタイプ |
| アウトガス温度 | 200℃ |
| 取付フランジ | CF63 |
| 電源 | 電源 X1、温度コントローラー X1 |
CBr4ガスモジュール
カーボンソースを使用する代わりに、キャリアガスを使用せずに(直接蒸発させて)四臭化炭素(CBr4)を使用することで、GaAs、AlGaAs、GaInAsPに高いドーピングレベルを達成することができます。ホール濃度は、GaAsで1×10^20 at/cm3 (CBr4 BEP~ 1×10^-6 Torr)、InGaAsで9×10^19 at/cm3が報告されています。CBr4ガスモジュールは、エピタキシャル材料に非常に正確で再現性の高いp型ドーピングが必要なあらゆるMBEアプリケーションでの使用を目的としています。超高純度(UHP)ガスパネルと超高純度UHVガスインジェクタの利点を組み合わせ、MBEチャンバへのCBr4の超低流量(< 5.10^-3 sccm)の導入を正確に制御することができます。安全性と操作性を重視した設計になっています。
ガスパネルとすべての必要なアクセサリーは、MBEシステム近くに簡単に設置できる安全ガスボックスに収められています。
四臭化炭素(CBr4)は、プロセスで使用できるように気相状態にします。蒸発は、加熱ジャケット(オプション)を介してCBr4シリンダーを加熱し、ソースとプロセス圧力制御システムを使用して蒸気の流れを制御することで実現します。供給ラインは、配管内の温度低下による凝縮を防ぐために、ヒーティングテープによって加熱されます。すべてのガスフローコンポーネント(シャットオフバルブ、バラトロン圧力レギュレータ、ラン/ベント スイッチング操作など)は、テストやメンテナンスのためにガスボックスのフロントパネルから操作することができます。 制御はCrystal XE MBEプロセスソフトウェアによって実行されます。プロセスガスの量が少ないため、MBE チャンバーに追加の排気システムは必要ありません。ただし、廃ガスは、腐食性ガス仕様のポンプを使って、排気およびベントラインから排出が必要になります。
適用蒸着材料
CBr4
特徴
・ 高ドーピングレベルと低ドーピングレベルに対応
・ 正確で再現性の高いp型ドーピング
・ 専用PLCと空圧バルブによる安全で容易な操作性
・ 高精度バラトロンによるフラックス調整
・ 組込み型ポンプ
CBr4ガスモジュール概要図
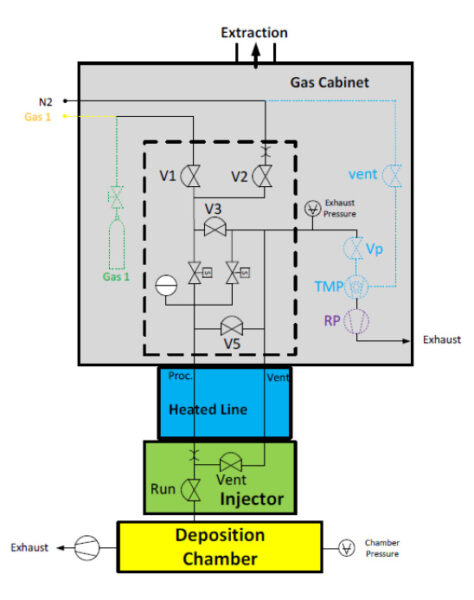
製品スペック表
| ガスキャビネットレイアウト | |
| サイズ(H x W x D) [mm] | 2200 x 600 x 550 |
| 支持脚/ ホイール数 | 4 |
| ドアロック | 1 |
| 警告、ステータス | 3色灯(ROG)、ブザー |
| ガスライン | 1系統 |
| ガス | |
| プロセスガス | CBr4 |
| CBr4コンディショニングシリンダー | Max φ55 x 160- VCR 1/4″-M(含まれていない) |
| 温度調節機能付きヒーティングジャケット | 30-95℃ +/- 2℃ |
| 温度調節機能付きガスラインヒーティング | 最大 60℃ +/-5℃ |
| 継手 | |
| N2導入継手 | VCR 1/4″-M |
| CDA導入継手 | コンプレッションフィッティングØ6(スウェージロック) |
| キャビネット排気接続径 [mm] | φ125 |
| ラン/ベントラインのホース径 [mm] | φ125 |
| ラフポート | KF16 |
| プロセスガス ランライン継手 | VCR 1/4″-F |
| プロセスガス ベントライン継手 | VCR 1/2″-F |
| ユーティリティー | |
| 電源 | 230 VAC-50Hz, 16 A |
| N2パージ入口圧力(絶対圧) | 1.0 < PN2 < 1.2 |
| CDA(絶対圧) | 4.5 < P < 8 bar |
| キャビネット排気速度 | >150 m3/h |
分子線エピタキシャル法の原理
分子線エピタキシャル法による分子線エピタキシー(MBE)は、エフュージョンセル(クヌーセンセル等)内のるつぼに入れた原料を加熱蒸発させ、基板上に到達させて結晶成長(エピタキシャル成長)を行う真空蒸着法の1つです。加熱蒸発の方法には抵抗加熱方式や電子ビーム照射方式などがあります。MBE は真空蒸着法の1つですが、MBEの特徴としては、チャンバ内を真空に引き,チャンバの周りを液体窒素で冷却することによってチャンバー圧力を高真空状態(~10-9torr 程度)に保ち蒸着を行うため、蒸発ガ ス分子の平均自由工程が長く、ガス分子はビーム状の分子線となって他の分子に衝突することなく基板表面に到達します。超高真空下にて成膜を行うため、残留ガスの影響を少なく抑える事ができ高品質の結晶膜が得られます。また膜厚の精密な制御も可能です。さらに RHEED(反射高速電子回折)等の結晶モニター等を用いて in-situ でモニターしながら、結晶成長条件へフィード バックすることが可能であり、このMBEの優れたフラックス制御性、界面の組成が原子レベルで急峻な組成を作製することができる為、化合物半導体デバイス向け結晶成長などに用いられます。

| Item# | Description |
| a | メインクライオパネル(シュラウド) |
| b | セルデバイダー |
| c | プラテンマニュピレーターおよびクライオパネル |
| d | 液体窒素フィードスルー |
| e | 分子線セル(蒸着源) |
製品メーカー案内

RIBER社(フランス)は、1964年に設立された分子線エピタキシャル成長装置(MBE装置)およびコンポーネント(MBEセル・蒸着源)を製造・販売する世界シェアNo.1のサプライヤーです。主にGaAsやInP、GaN等の化合物半導体材料の成膜用途として累計約800台の装置を世に送り出してきました。現在、世界の主要大学や公的研究機関、デバイスメーカー、エピファウンドリー各社がRIBER社のMBE装置を運用しており、データ通信、5G/6G、VCSELレーザー、フォトニクス、センサー、3Dセンシングなど様々な最先端分野の研究または生産ツールとして貢献しています。
日本国内では、伯東株式会社が総代理店として、同社製品の販売と保守サービスを提供しております。
APPLICATION
アプリケーション-

半導体レーザー
今日、半導体レーザーは、通信・レーザー切断・計測など様々なシーンで使用される重要なツールです。Riber社のMBEソリューションは、究極のスペクトル狭さと低欠陥密度を可能にし、レーザーの特性と信頼性を強化します。
-

赤外線センサー
赤外線センサーの多くは、MBEエピタキシャルウエハから作られています。昨今III-V族エピによる新世代の赤外線センサーが出現し、ガス検出や人感センサーなど幅広く応用されています。
-

ディスプレイ
マイクロLEDはMBEが重要な役割を持つ分野です。MBEはGaNにおける高In組成を容易に実現できるため、蛍光体を使わずに可視スペクトルをカバーすることができます。Riber社はMBE装置と蒸発源の豊富なポートフォリオにより、次世代ディスプレイ製造のソリューションを提供します。


