多種多様なRFプラズマ源(プラズマソース)
RIBER(リベール)
RFプラズマ源
RFシリーズ、VRFシリーズ、RF-Hシリーズ
RIBER社製RFプラズマ源は、ラジカル状の窒素、酸素、水素を供給するプラズマソースです。MBEエピタキシャル成長の重要なツールとして豊富な実績があり、研究から生産までのお客様のニーズに対応しています。窒化物(GaN, InN, AlN)、希釈窒化物(GaInAsN、II-VI族系ドーピング)、酸化物(ZnO、スピントロニクス、High-K)、希薄酸化物(ドーピング、混合窒化物/酸化物)、およびウエハ表面クリーニングなどに適用可能なRFプラズマ源を幅広く提供しています。
SERIES LINEUP
シリーズラインナップ-
窒素/酸素 高速RFプラズマ源

RFシリーズ
RIBER社製RFプラズマ源は全世界で80台以上の高速RFプラズマ源が設置しており、研究から生産までの機種をラインナップ。高プラズマ安定性、再現性、効率的ガス消費を実現。
-
希釈窒化/酸化物 バルブRFプラズマ源

VRFシリーズ
RIBER社製バルブドRFプラズマ源は、制御性が良く、バルブが閉じている間、プラズマ条件を保持することができ、プラズマの起動と安定化を待つ必要なく、すぐに使用することができます。
-
水素RFプラズマ源

RF-Hシリーズ
RIBER社製水素RFプラズマ源は、ウェハの洗浄工程を支援する重要なソリューションであり、単純な熱アニール処理よりもスムーズなプロセスを実現し、ウェハへの熱負荷を低減することで表面劣化を防ぎます。
窒素/酸素 高速RFプラズマ源(RFシリーズ)
RIBER社製分子線エピタキシャル装置向けRFプラズマ源は市場で多数使用されており、研究から生産までお客様のニーズに対応しています。ラジカル窒素種またはラジカル酸素種の分子線フラックスを供給し、窒化物(GaN, InN, AlN)、希薄窒化物(GaInAsN、II-VI族系ドーピング)、酸化物(ZnO、スピントロニクス、high-K)、希薄酸化物(ドーピング、窒化物と酸化物の混合)など、さまざまなアプリケーションに対応しています。RFソース構成は、セル本体、キャビティー(プラズマ放電管)、マッチングボックス(RF発生器)とシンプルです。また、フラックス安定化のために、プラズマ発光診断ツール(OED:Optical Emission Diagnostics)を導入することも可能です。
マスフローコントローラやガス精製器、バルブ類には半導体グレードが使用されています。また、ガスの混合が必要な場合は、デュアルガスインジェクションパネルが利用可能です。
動作原理
RFプラズマソースは、キャビティーを囲むRFコイルの誘導結合によって生じる電界によって動作します。RF(13.56MHz)ジェネレーターは、放電キャビティー空間内に電力を供給します。プラズマへの電力伝達を最大化するために、インピーダンスマッチングします。キャビティー空間のプラズマは、分子種の解離によって原子を生成します。原子は、解離していない分子とともに、キャビティーのフロントディスク(「エンドプレート」)にある小さな穴の配列(パターン)を通って真空チャンバ内に流れ込みます。このパターンは用途によって異なります。大きなフラックスを必要とする場合には多数の穴が必要となります。一般に原子は再結合係数が非常に小さいので、数回の衝突を受けた原子でも最終的には原子ビームのフラックスに寄与します。
キャビティー内の壁を覆う電子シート、穴の大きさや形状は、キャビティーから放出されるイオンや電子を最小限に抑えるように設計されています(電流は10nA/cm2以下)。
キャビティー内の圧力が一定以上になると、ガスのブレークダウンが起こります。この圧力は、ガスのイオン化ポテンシャルに依存します。その結果、特定のキャビティーパターンでは、分子ガスの流量はガスごとに異なります。
プラズマの状態は、フラックスの安定性と組成を確認するために、発光診断ツール OEDによってモニターされます。
適用蒸着材料
N2,O2
特徴
・ 研究から量産までの機種をラインナップ
・ 最適化された活性種の生成
・ 窒化物、酸化物エピ成長用に設計されたRFプラズマ源
・ 高いプラズマ安定性と再現性
・ GaN高速成長が可能
・ スピントロニクス、高誘電率アプリケーション、ペロブスカイト、MgZnOおよび関連酸化物に最適
・ プラズマ発光強度検出による優れた成長レート制御
・ オートマッチャー標準装備および完全ソフトウエア制御
・ 効率的なガス消費と信頼性の高い設計
・ 全世界で80台以上の高速RFプラズマ源を設置(2020年時点)
窒素/酸素 高速RFプラズマ源概要図
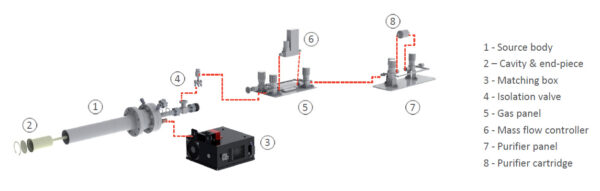
製品スペック表
| 特性 | RF-N 50/63 | RF-O 50/63 |
| キャビティー材料 | PBN | 石英 |
| キャビティータイプ | エンドピース付きキャビティー | エンドピース付きキャビティー |
| 取付フランジ | CF63(最小)-適合可能サイズ | CF63(最小)-適合可能サイズ |
| RFチューニングユニット | オートマッチングBOX(X2) マニュアルマッチングにも対応可能 | オートマッチングBOX(X2) マニュアルマッチングにも対応可能 |
| 電源 | 600W | 600W |
| プラズマ観察ビューポート | CF16 | CF16 |
| アイソレーションバルブ | 有 | 有 |
| ガス導入継手 | DN CF16 /VCR 1/4″ | DN CF16 /VCR 1/4″ |
| RFコイル水冷 | 有 φ6mm スウェージロック接続 DP> 2bars, 0.3L/min | 有 φ6mm スウェージロック接続 DP> 2bars, 0.3L/min |
| RFチューニングユニット冷却 | 空冷 | 空冷 |
| 冷却水安全スイッチ | 有 | 有 |
| オプション | プラズマ発光検出 | プラズマ発光検出 |
| 偏向板 | 偏向板 | |
| ガスパネル+マスフローコントローラー | ガスパネル+マスフローコントローラー | |
| ガス精製パネル | ガス精製パネル |
希釈窒化/酸化物 バルブドRFプラズマ源(VRFシリーズ)
分子線エピタキシャル装置向けの標準的なRFプラズマソースと比較して、この新しいプラズマ源は、バルブドクラッカーセルのように高い制御性を有しています。バルブが閉じている間、同じプラズマ状態を保持することができ、標準的なRFソースで必要とされるようなプラズマの起動と安定化を待つ必要なく、すぐに使用することができます。特許取得済みの設計は、迅速で再現性のある反応性窒素種の流量調整と、大口径ウェハー上で卓越した窒素濃度の均一性を実現します。大型のプラテン上で高い均一性が要求される場合(生産システム用)、大口径RFセルを使用する他のソリューションと比較して、チャンバー内の動作圧力に関してメリットがあります。分子状窒素の流れは、大きなエンドプレートダイアフラムを備えた標準的なRFソースでは数十sccmであるのに対し、RIBER社 バルブ RFソースでは数sccmになります。これにより、システム内の動作圧力を低くし、より良いプロセス条件が得られます。ガスの混合が必要な場合は、デュアルガスインジェクションパネルが利用できます。
動作原理
RFプラズマソースは、キャビティーを囲むRFコイルの誘導結合によって生じる電界によって動作します。RF(13.56MHz)ジェネレーターは、放電キャビティー空間内に電力を供給します。プラズマへの電力伝達を最大化するために、インピーダンスマッチングします。キャビティー空間のプラズマは、分子種の解離によって原子を生成します。原子は、解離していない分子とともに、キャビティーのフロントディスク(「エンドプレート」)にある小さな穴の配列(パターン)を通って真空チャンバ内に流れ込みます。このパターンは用途によって異なります。大きなフラックスを必要とする場合には多数の穴が必要となります。一般に原子は再結合係数が非常に小さいので、数回の衝突を受けた原子でも最終的には原子ビームのフラックスに寄与します。VRF-Nの最大の特徴は、窒素の流量をバルブで制御していることです。一般的なRFプラズマ源とは異なり、ディフューザーのモデルを変更することなく、バルブによって窒素流量を可変・調整・最適化することが可能です。
キャビティー内の壁を覆う電子シート、穴の大きさや形状は、キャビティーから放出されるイオンや電子を最小限に抑えるように設計されています(電流は10nA/cm2以下)。キャビティー内の圧力が一定以上になると、ガスのブレークダウンが起こります。この圧力は、ガスのイオン化ポテンシャルに依存します。その結果、特定のキャビティーパターンでは、分子ガスの流量はガスごとに異なります。プラズマの状態は、フラックスの安定性と組成を確認するために、発光診断ツール OEDによってモニターされます。
適用蒸着材料
N2,O2
特徴
・ 希釈窒化物アプリケーションに最適な設計
・ 希釈された窒化物を0~10%まで急速に変化させる特許取得済みの設計
・ プラズマ安定化時間無しですぐに使用可能
・ エンドピースの交換不要
・ イオン種を完全除去し、エピ層中の欠陥を最小限に抑えます
・ 再現性のある反応種の生成
・ 非常に高い均一性を実現
希釈窒化/酸化物 バルブドRFプラズマ源概要図

製品スペック表
| 特性 | VRF-N 600 | VRF-O 600 |
| キャビティー材料 | PBN | 石英 |
| キャビティータイプ | シングルピースキャビティー | シングルピースキャビティー |
| 取付フランジ | CF63(最小)-適合可能サイズ | CF63(最小)-適合可能サイズ |
| RFチューニングユニット |
オートマッチングBOX(X2) マニュアルマッチングにも対応可能 |
オートマッチングBOX(X2) マニュアルマッチングにも対応可能 |
| 電源 | 600W | 600W |
| プラズマ観察ビューポート | CF16 | CF16 |
| フラックスバルブ | 統合(Integrated), モーターコントロールマイクロメータ | 統合(Integrated), モーターコントロールマイクロメータ |
| アイソレーションバルブ | 有 | 有 |
| ガス導入継手 | DN CF16 /VCR 1/4″ | DN CF16 /VCR 1/4″ |
| RFコイル水冷 | 有 φ6mm スウェージロック接続 DP> 2bars, 0.2L/min | 有 φ6mm スウェージロック接続 DP> 2bars, 0.2L/min |
| RFチューニングユニット冷却 | 空冷 | 空冷 |
| 冷却水安全スイッチ | 有 | 有 |
水素 RFプラズマ源(RF-Hシリーズ)
分子線エピタキシャル装置向け水素RFプラズマ源は、ウェハの洗浄工程を支援する重要なソリューションであり、単純な熱アニール処理よりもスムーズなプロセスを実現し、ウェハへの熱負荷を低減することで表面劣化を防ぎます。放電用の一体型キャビティには、反応性水素種用のソースを構成するためのPBN材料が用意されています。水素RFプラズマソース構成は、キャビティー、セル本体、マッチングボックス(RF発生器、ケーブル、ウォータースイッチで構成)とシンプルです。また、ガスラインに直接設置できるアイソレーションバルブも用意されています。フラックスの安定化のために、OED(Optical Emission Diagnostics)を導入することも可能です。また、オプションでシャッターもご用意しています。マスフローコントロール、ガス精製、駆動用電子機器には、半導体グレードのガスパネルが用意されています。また、ガスの混合が必要な場合は、デュアルガスインジェクションパネルも利用可能です。
動作原理
RFプラズマソースは、キャビティーを囲むRFコイルの誘導結合によって生じる電界によって動作します。RF(13.56MHz)ジェネレーターは、放電キャビティー空間内に電力を供給します。プラズマへの電力伝達を最大化するために、インピーダンスマッチングします。キャビティー空間のプラズマは、分子種の解離によって原子を生成します。原子は、解離していない分子とともに、キャビティーのフロントディスク(「エンドプレート」)にある小さな穴の配列(パターン)を通って真空チャンバ内に流れ込みます。このパターンは用途によって異なります。大きなフラックスを必要とする場合には多数の穴が必要となります。一般に原子は再結合係数が非常に小さいので、数回の衝突を受けた原子でも最終的には原子ビームのフラックスに寄与します。
キャビティー内の壁を覆う電子シート、穴の大きさや形状は、キャビティーから放出されるイオンや電子を最小限に抑えるように設計されています(電流は10nA/cm2以下)。
キャビティー内の圧力が一定以上になると、ガスのブレークダウンが起こります。この圧力は、ガスのイオン化ポテンシャルに依存します。その結果、特定のキャビティーパターンでは、分子ガスの流量はガスごとに異なります。
プラズマの状態は、フラックスの安定性と組成を確認するために、発光診断ツール OEDによってモニターされます。
適用蒸着材料
H2
特徴
・ 研究から量産までの採用実績
・ 最適な反応種の生成
・ 水素を利用したウェーハ洗浄に最適:クリーンで滑らかな表面を維持
・ 効率的なガス消費と信頼性の高い設計
・ 世界で50台以上の水素プラズマ源を設置(2020年時点)
水素 RFプラズマ源概要図
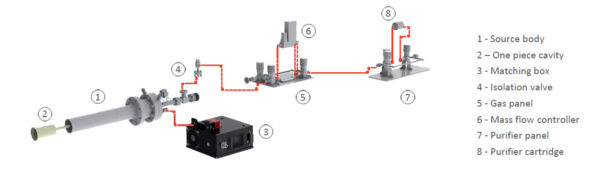
製品スペック表
| 特性 | RF-H 600 |
| キャビティー材料 | PBN |
| キャビティータイプ | 1ピースキャビティー |
| 取付フランジ | CF63(最小)-適合可能サイズ |
| RFチューニングユニット | オートマッチングBOX(X2) マニュアルマッチングも対応可能 |
| 電源 | 600W |
| プラズマ観察ビューポート | CF16 |
| アイソレーションバルブ | 有 |
| ガス導入継手 | DN CF16 /VCR 1/4″ |
| RFコイル水冷 | 有-φ6mm スウェージロック接続 DP> 2bars, 0.3L/min |
| RFチューニングユニット冷却 | 空冷 |
| 冷却水安全スイッチ | 有 |
| オプション | プラズマ発光検出 |
| 偏向板 | |
| シャッター | |
| ガスパネル+マスフローコントローラー | |
| ガス精製パネル |
分子線エピタキシャル法の原理
分子線エピタキシャル法による分子線エピタキシー(MBE)は、エフュージョンセル(クヌーセンセル等)内のるつぼに入れた原料を加熱蒸発させ、基板上に到達させて結晶成長(エピタキシャル成長)を行う真空蒸着法の1つです。加熱蒸発の方法には抵抗加熱方式や電子ビーム照射方式などがあります。MBE は真空蒸着法の1つですが、MBEの特徴としては、チャンバ内を真空に引き,チャンバの周りを液体窒素で冷却することによってチャンバー圧力を高真空状態(~10-9torr 程度)に保ち蒸着を行うため、蒸発ガ ス分子の平均自由工程が長く、ガス分子はビーム状の分子線となって他の分子に衝突することなく基板表面に到達します。超高真空下にて成膜を行うため、残留ガスの影響を少なく抑える事ができ高品質の結晶膜が得られます。また膜厚の精密な制御も可能です。さらに RHEED(反射高速電子回折)等の結晶モニター等を用いて in-situ でモニターしながら、結晶成長条件へフィード バックすることが可能であり、このMBEの優れたフラックス制御性、界面の組成が原子レベルで急峻な組成を作製することができる為、化合物半導体デバイス向け結晶成長などに用いられます。

| Item# | Description |
| a | メインクライオパネル(シュラウド) |
| b | セルデバイダー |
| c | プラテンマニュピレーターおよびクライオパネル |
| d | 液体窒素フィードスルー |
| e | 分子線セル(蒸着源) |
製品メーカー案内

RIBER社(フランス)は、1964年に設立された分子線エピタキシャル成長装置(MBE装置)およびコンポーネント(MBEセル・蒸着源)を製造・販売する世界シェアNo.1のサプライヤーです。主にGaAsやInP、GaN等の化合物半導体材料の成膜用途として累計約800台の装置を世に送り出してきました。現在、世界の主要大学や公的研究機関、デバイスメーカー、エピファウンドリー各社がRIBER社のMBE装置を運用しており、データ通信、5G/6G、VCSELレーザー、フォトニクス、センサー、3Dセンシングなど様々な最先端分野の研究または生産ツールとして貢献しています。
日本国内では、伯東株式会社が総代理店として、同社製品の販売と保守サービスを提供しております。
APPLICATION
アプリケーション-

半導体レーザー
今日、半導体レーザーは、通信・レーザー切断・計測など様々なシーンで使用される重要なツールです。Riber社のMBEソリューションは、究極のスペクトル狭さと低欠陥密度を可能にし、レーザーの特性と信頼性を強化します。
-

赤外線センサー
赤外線センサーの多くは、MBEエピタキシャルウエハから作られています。昨今III-V族エピによる新世代の赤外線センサーが出現し、ガス検出や人感センサーなど幅広く応用されています。
-

ディスプレイ
マイクロLEDはMBEが重要な役割を持つ分野です。MBEはGaNにおける高In組成を容易に実現できるため、蛍光体を使わずに可視スペクトルをカバーすることができます。Riber社はMBE装置と蒸発源の豊富なポートフォリオにより、次世代ディスプレイ製造のソリューションを提供します。


